|
掃瞄探針顯微鏡(Scanning Probe Microscope, SPM)是利用各種奈米尺度探針以掃瞄方式將尖端所得到之表面訊息組成表面原子影像,亦可利用針尖外加偏壓形成強大尖端電場,產生電化學反應,氧化部分樣品表面再以溶劑(如:KOH)蝕刻(etching)之方式製作奈米(  )結構即所謂直書(direct-write);SPM包括掃瞄穿隧顯微鏡(Scanning Tunneling Microscope, STM)、原子力顯微鏡(Atomic Force Microscope, AFM)及眾多衍生產品,其具有較佳的垂直解析度及水平解析度,但最大的缺點為量測之行程範圍仍有限,約數十微米。 )結構即所謂直書(direct-write);SPM包括掃瞄穿隧顯微鏡(Scanning Tunneling Microscope, STM)、原子力顯微鏡(Atomic Force Microscope, AFM)及眾多衍生產品,其具有較佳的垂直解析度及水平解析度,但最大的缺點為量測之行程範圍仍有限,約數十微米。
掃瞄穿隧顯微鏡,如圖(a)所示,是利用針尖至樣品間穿隧電流之大小與其距離之關係,量測樣品表面高度變化而得到原子影像。原子力顯微鏡,如圖(b)所示,則是利用探針與表面原子之作用力,造成懸臂樑(cantilever)之偏移,而量測得到原子影像。因STM之穿隧電流與距離成指數關係,所以對距離有很高的敏感度,可達原子級之解析度,優於AFM;但STM以電流之方式呈像,只能觀察導體材料,而AFM對導體、非導體都可觀察。圖(c)  和 和  分別為懸臂樑之縱向撓度(vertical deflection)與扭轉撓度(torsional deflection)在垂直與水平影像檢測器(photodetector)上之訊號。 分別為懸臂樑之縱向撓度(vertical deflection)與扭轉撓度(torsional deflection)在垂直與水平影像檢測器(photodetector)上之訊號。
|
(a) |
|
|
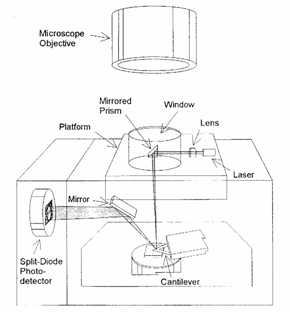
|
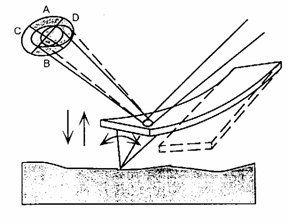
|
|
(b) |
(c) |
當探針開始接近樣品時,如圖(d)所示,因凡得瓦爾力(Van der Waals Force)的關係使其彼此產生相互吸引之作用力,但若探針繼續接近樣品時,探針與樣品上原子之外圍電子,將會產生彼此相互排斥的作用力,此力隨距離縮小而加大,當抵消所有的吸引力就完全由排斥力所控制。
|

|
|
(d) |
探針針尖的幾何形狀會影響到原子力顯微鏡之呈像,圓鈍探針將有較大的接觸面積與污染物作用,使污染物對其產生更強之吸力;尖銳探針與污染物之接觸面積較小,則作用力小同時與樣品間之毛細管吸力(Capillary Attraction)也較低,故尖銳探針較圓鈍探針更易在樣品表面上下移動。
就呈像模式而言,原子力顯微鏡可分為接觸式與非接觸式。其中接觸式之呈像模式,為探針與樣品在排斥力範圍內作用,此時懸臂樑被推離樣品;非接觸式之呈像模式,則為探針與樣品在吸引力範圍內作用,懸臂樑彎向樣品。
接觸式呈像又可分為固定力作用(Constant Force)掃瞄與可變力作用(Variable Force)掃瞄:固定力作用掃瞄,是藉由迴授電路與壓電材料之伸縮,將探針始終保持與樣品等距離,而控制壓電材料伸縮之電壓,則取樣為樣品表面Z方向結構之資料值,亦稱慢速掃瞄式,因其可利用迴授隨時調整探針高低,所以適於掃瞄較大範圍,即樣品表面傾斜度大也不致使探針碰撞樣品而損壞;可變作用力掃瞄,為關閉迴授系統不去調整探針高低直接快速掃瞄,藉其與樣品間因表面起伏而改變彼此之相對距離,當距離改變則相互作用力改變,使懸臂樑產生偏移,此偏移由偵測器得到樣品表面Z方向結構之資料值,因無法控制探針高低故僅適合掃瞄小範圍,又因關閉迴授電路可避免電路雜訊干擾,所以可達原子級解析度。
非接觸呈像模式可分為低振幅共振掃瞄與高振幅共振掃瞄,皆是以一共振頻率驅動懸臂樑,掃瞄時因探針與樣品間相互作用力改變使懸臂樑之共振頻率改變、振幅改變,利用比較驅動頻率或振幅與偵測器所測到之頻率或振幅,即可得到樣品表面 方向結構之資料值。低振幅共振掃瞄適於污染物較薄之樣品,否則會降低其解析度;高振幅共振頻率雖不受此限,但探針容易打擊在樣品上而破壞樣品表面結構,故一般非接觸式掃瞄多用於較軟之樣品呈像。 |